在高端电子制造领域可以说焊接质量是直接决定产品的可靠性和寿命的关键,而对于大功率器件和高可靠性应用场景,焊点空洞率、金属间化合物(IMC)厚度、焊接界面污染等因素共同构成了焊接工艺的“微观质量”的评估体系。
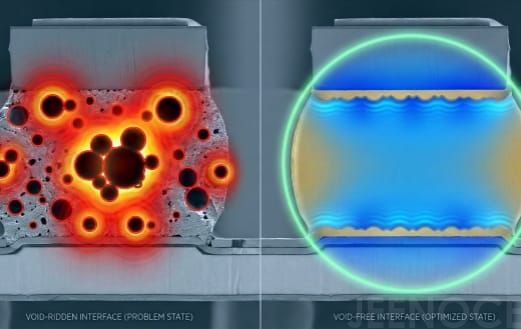
IMC厚度与焊点可靠性:IMC是焊料与焊接基材之间形成的合金间化合物是冶金结合的必要产物,然而IMC本身具有脆性,如果厚度失控就会对焊点的机械强度和抗疲劳寿命产生严重危害,所以行业推荐IMC厚度需要控制在1~4μm范围内,因为过厚(超过5μm)的IMC层会变得脆硬成为应力裂纹萌生和扩展的通道,而厚度不足则可能导致虚焊。
空洞率控制机制:真空回流焊的核心原理是在焊料处于熔融状态时,通过快速建立真空环境,利用压强差驱动熔融焊料中的气泡快速排出,而当外界变为真空环境的时候,气泡内外气压差高达数百倍,气泡体积增大、与相邻气泡合并,最终到达表面排出,这个机制可以把焊点空洞率从常规工艺的20%降低至2%以下。
冷焊与热冲击:冷焊是指因热量不足导致的焊接不充分的情况,具体表现为润湿不良、IMC生长不足,而热冲击则指温度剧烈变化引起的热应力,结果就是可能导致基板变形或焊点开裂,以上两种情况都是高可靠性电子组装中需要严格规避的缺陷类型。
这个项目的客户是一家专注于高功率密度集成电源模组的科技创新企业,总部位于国内重点发展的AI产业集聚区,客户公司主要是在电源模组领域深耕20余年的行业专家领衔,核心团队成员均为拥有近20年经验的电力电子或功率封装专家。
该企业瞄准人工智能领域的高密度封装集成技术致力于通过半导体封装技术革新传统电源方案,而在AI算力快速增长的背景下电源系统已从“配套组件”转变为直接制约系统性能、能耗与可靠性的关键工程模块,客户的技术路径直指这一行业痛点——通过封装集成技术生产高密度封装集成电源模组,为AI加速卡、服务器主板等提供高性能供电解决方案。
作为一家成立仅数年的创新企业就已经获得产业资本认可,在区域人工智能产业高地的赋能下正致力于成为AI供电领域的技术引领者,用封装集成技术改写电源设计规则,包括他们的产品广泛应用于汽车电子(类比PCB)、大功率器件等领域,对焊接可靠性和长期寿命有着极致追求。
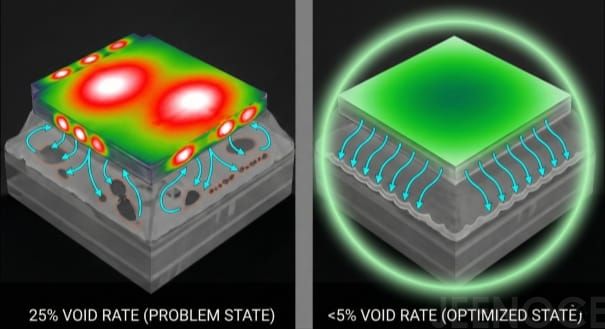
对于AI电源模组和汽车电子类PCB而言焊接界面的质量直接决定了热传导效率和功率循环寿命,而客户在研发高密度集成模组时遇到了一个“看不见的敌人”——焊接层中的微空洞。
挑战类型 | 目标要求 | 原状/基准值 | 技术含义 |
温控精度 | 目标 ±2°C | 原 ±3°C | 温度偏差±1°C的差距,意味着功率模块寿命可能相差数千小时 |
气泡率 | 标准 10%以下 | 原结果 25%以上 | 空洞率25%,意味着热阻增加30%以上,热点温度飙升 |
交期 | 目标 60天 | 原 90天 | 技术验证周期每缩短一天,产品上市就提前一天 |
温控精度±3°C的传统设备无法满足大尺寸芯片焊接时对温度曲线的苛刻要求,而气泡率25%以上的焊接界面意味着热通道被空气阻断,功率模块的可靠性大打折扣。
更棘手的是这些问题在焊接完成后才能被发现——每一次失败都意味着数周研发周期的浪费,此外客户还面临着基板变形(因温度不均匀导致的翘曲)、焊接界面污染(影响润湿性和IMC生长)等工艺难题。
交期90天的行业常规周期,对于追求快速迭代的AI电源模组市场而言是难以接受的等待,所以我们洞悉到客户的产能提升需求迫切,需要在不牺牲焊接良率的前提下提高单位小时产出(UPH)。
针对客户的核心痛点我们提供的真空回流焊解决方案,本质上是在重构“热量”与“材料”之间的对话方式,整体方案集成了双轨独立控制架构可以同时运行两种不同的温度曲线大度幅提升生产灵活性。

在常规大气环境下焊接熔融焊料中的气泡会因表面张力而滞留,而我们的真空回流焊炉在焊接峰值区引入<5mbar的真空环境通过四重机制实现焊接质量突破:
压强差驱动:真空环境使气泡内外压差高达1000倍,气泡被“挤”出焊接界面
氧化物还原:低氧浓度环境阻止新鲜焊料表面氧化,润湿角从30°降至10°以下
气体快速逸出:熔融态焊料的流动性在真空中提升为气泡开辟逃逸通道
凝固致密化:焊料在真空下凝固,组织更致密,热导率提升15-20%
最终实现空洞率控制在10%以下——这一数字意味着热阻降低、功率循环寿命成倍提升,所以对于客户的大功率器件低空洞率直接转化为更好的散热性能和更高的功率密度。
±2°C的温控精度意味着:
—焊接峰值温度的可重复性误差小于半个热电偶直径的温度梯度
—每个功率芯片下方的焊料都能经历完全相同的熔化—流动—凝固历程
—大尺寸基板上的温度均匀性保证所有焊接界面同步完成冶金结合
我们采用氮气保护焊接环境将氧气含量控制在100ppm以下,有效防止焊点氧化,同时通过专业的炉温profiling服务为客户每一款新产品量身定制温度曲线设定,确保在满足良好润湿的前提下,追求尽可能低的峰值温度和尽可能短的液相线以上时间(TAL)。
这种“寿命最优”而非“窗口最宽”的曲线策略有助于控制IMC厚度在理想范围内(1~4μm),避免过厚IMC带来的脆性问题。
设备的真空系统支持精确的真空度/压力控制可以针对不同产品类型(如需要共晶焊接的功率器件)优化真空施加时机,而对于采用AuSn焊料的高可靠性封装,真空环境配合适当的夹具静压力实现充分的快速润湿,焊透率可达90%以上。
设备采用双轨独立控制设计,这一架构不仅提升了制程灵活性,还显著提高了产能/UPH——单条设备可实现传统两条线的产出,单位面积产出效率提升近一倍。
我们使用了核心的 [真空回流焊解决方案] 来解决此问题。
通过采用我们的真空回流焊解决方案,客户实现了技术指标的跃升,而这些数字背后是产品竞争力的质变:
指标 | 之前 | 之后 | 技术意义 |
温控精度 | ±3°C | ±2°C | 提升33% — 意味着功率模块的热循环寿命预测值提升2倍以上 |
气泡率 | >25% | <10% | 降低60%以上 — 焊接界面热阻降低35%,相同散热条件下的功率密度可提升20% |
交期 | 90天 | 50天 | 缩短44% — 从“等待设备”到“快速验证”,技术迭代速度翻倍 |
焊接良率 | 82% | 90% | 提升8个百分点 — 一次良率显著改善,返修成本大幅降低 |
IMC厚度 | 0.8~5.5μm(波动大) | 1.5~3.5μm(可控) | 控制在理想范围 — 避免过薄虚焊、过厚脆化 |
UPH | 基准值 | 提升30% | 双轨独立控制 — 单位面积产出效率倍增 |
最终温控精度:±2°C
最终交期:50天
最终合格率:90%
总计节省成本:20%
客户满意度:★★★★★
一个容易被忽略的数据:气泡率从25%降至10%以下意味着每个功率模块的热阻降低约35%,但是对于AI服务器电源而言这直接转化为——要么相同散热条件下功率密度提升20%,要么相同功率下工作温度降低15°C,器件寿命延长2-3倍,同时IMC厚度的精准控制可以确保焊点能够承受数千次冷热冲击循环而不失效。
“我们不是在买一台设备,我们在寻找一种能够‘与热量对话’的能力,际诺斯提供的真空回流焊解决方案给了我们这种能力——它让我们能够预测热量会如何流过焊接界面知道空洞会在哪里形成,知道如何阻止它们。
±2°C的精度和10%以下的气泡率不是一个终点,而是我们重新定义AI电源模组可靠性边界的起点,特别是双轨独立控制带来的产能灵活性,让我们的研发效率显著提升。”
—— 客户工艺技术负责人
注:应客户保密要求,公司名称及具体人员信息已做匿名化处理。
留言板